
基本光刻工艺流程
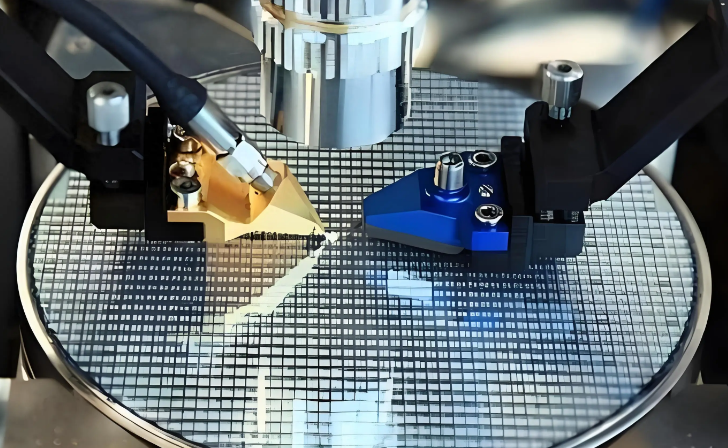
1、光刻工艺是一种用来去掉晶圆表面层上所规定的特定区域的基本操作(Photolithography、Photomasking、Masking、Oxide、MetalRemoval-OR,MR、Microlithography)
负胶+亮场或正胶+暗场形成空穴;负胶+暗场或正胶+亮场形成凸起;
2、光刻十步法:
表面准备—涂光刻胶—软烘焙—对准和曝光—显影—硬烘焙—显影目测—刻蚀—光刻胶去除—最终目检;
3、基本的光刻胶化学物理属性:
a、组成:聚合物+溶剂+感光剂+添加剂
普通应用的光刻胶被设计成与紫外线和激光反应,它们称为光学光刻胶(opticalresist),还有其它光刻胶可以与X射线或者电子束反应;
负胶:聚合物曝光后会由非聚合态变为聚合状态,形成一种互相粘结的物质,是抗刻蚀的,大多数负胶里面的聚合物是聚异戊二烯类型的,早期是基于橡胶型的聚合物;
正胶:其基本聚合物是苯酚-甲醛聚合物,也称为苯酚-甲醛Novolak树脂,聚合物是相对不可溶的,在用适当的光能量曝光后,光刻胶转变成可溶状态;
b、光刻胶的表现要素:
分辨率:resolutioncapability、纵横比-aspectratio(光刻胶厚度与图形打开尺寸的比值、正胶一般比负胶有更高的纵横比);
粘结能力:负胶的粘结能力通常比正胶强一些;
曝光速度、灵敏性和曝光源:反应速度越快,在光刻蚀区域晶圆的加工速度越快;灵敏性是与导致聚合或者光溶解发生所需要的能量总和相关的;波长越短的射线能量越高;
工艺宽容度:工艺维度越宽,在晶圆表面达到所需要尺寸的可能性就越大;
针孔:针孔是光刻胶层尺寸非常小的空穴,光刻胶层越薄,针孔越多,典型的权衡之一;
微粒和污染水平、阶梯覆盖度和热流程;
c、正胶和负胶的比较:
直到20世纪70年代中期,负胶一直在光刻工艺中占主导地位,到20世纪80年代,正胶逐渐被接受。两者相比优缺点如下:正胶的纵横比更高、负胶的粘结力更强曝光速度更快、正胶的针孔数量更好阶梯覆盖度更好,但成本更高、正胶使用水溶性溶剂显影而负胶使用有机溶剂显影;
d、光刻胶的物理属性:
固体含量:solidcontent一般在20%-40%;
粘度:测试方法有落球粘度计量器、Ostwalk-Cannon-Fenske方法、转动风向标法、粘度单位是厘泊(centipoise),另一种单位称为kinematic粘度,它是centistoke,由粘度(厘泊)除以光刻胶密度而得到,默认温度为25度;
表面张力;
折射系数:indexofrefraction,对于光刻胶其折射率和玻璃接近约为1.45;
储存与控制:光热敏感度、粘性敏感度、清洁度……
4、光刻工艺剖析:
a、表面准备:
微粒清除:高压氮气吹除、化学湿法清洗、旋转刷刷洗、高压水流;
脱水烘焙:低温烘焙(150~200℃),憎水性-hydrophobic\xa0亲水性-hydrophilic
晶圆涂底胶:HMDS(六甲基乙硅烷)沉浸式涂底胶、旋转式涂底胶、蒸气式涂底胶;
b、涂光刻胶:
普通的光刻胶涂胶方法有三种:刷法、滚转方法和浸泡法,IC封装用光刻胶的涂布方法如下:
静态涂胶工艺、动态喷洒、移动手臂喷洒、手动旋转器、自动旋转器、背面涂胶;
c、软烘焙:
热传递的三种方式:传导、对流和辐射;
常用的软烘焙加热方式如下:对流烘箱、手工热板、内置式单片晶圆加热板、移动带式热板、移动带式红外烘箱、微波烘焙、真空烘焙、
d、对准和曝光(A&E):
对准系统的性能表现:对准系统包含两个主要子系统、一个是要把图形在晶圆表面上准备定位,另一个是曝光子系统,包括一个曝光光源和一个将辐射光线导向晶圆表面上的机械装置;
对准与曝光系统:光学(接触式、接近式、投影式、步进式),非光学(X射线、电子束);
曝光光源:高压汞灯、准分子激光器、X射线及电子束;
对准法则:第一个掩膜版的对准是把掩膜版上的Y轴与晶圆上的平边成90°放置,接下来的掩膜都用对准标记(又称靶)与上一层带有图形的掩膜对准。对准误差称为未对准(misalignment);
光刻机的分类:接触式光刻机、接近式光刻机、扫描投影光刻机、步进式光刻机、分布扫描光刻机、X射线光刻机、电子束光刻机、混合和匹配光刻机;
曝光后烘焙(PEB):驻波是使用光学曝光和正性光刻胶时出现的问题,一种减少驻波效应的方法是在曝光后烘焙晶圆,PEB的时间和温度的规格是烘焙方法、曝光条件以及光刻胶化学所决定的。
总结:以上为小编总结的光刻工艺流程,希望大家喜欢。
上一篇:MEMS技术及其应用详解
下一篇:soi工艺的应用及优点


