
在半导体制造领域,深硅刻蚀是一项关键技术,它涉及到使用化学或物理方法在硅片上制造出高精度的微结构。这项技术对于制造高性能的微电子器件至关重要,比如微机电系统(MEMS)和集成电路(IC)。随着科技的不断进步,深硅刻蚀技术也在不断发展,以满足更高性能和更小尺寸的需求。
刻蚀工艺的特性
“刻蚀”工艺具有很多重要的特性。所以,在了解具体工艺之前,有必要先梳理一下刻蚀工艺的重要术语
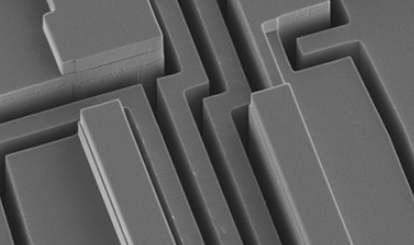
第一个关键术语就是“选择比”,该参数用于衡量是否只刻蚀了想刻蚀的部分。在反应过程中,一部分光刻胶也会被刻蚀,因此在实际的刻蚀工艺中,不可能100%只刻蚀到想移除的部分。一个高选择比的刻蚀工艺,便是只刻蚀了该刻去的部分,并尽可能少地刻蚀到不应该刻蚀材料的工艺。
第二个关键词,就是“方向的选择性”。顾名思义,方向的选择性是指刻蚀的方向。该性质可分为等向性(Isotropic)和非等向性(Anisotropic)刻蚀两种:等向性刻蚀没有方向选择性, 除纵向反应外,横向反应亦同时发生;非等向性刻蚀则是借助具有方向性的离子撞击来进行特定方向的刻蚀,形成垂直的轮廓。试想一个包裹糖果的包装袋漏了一道口子,如果把整块糖连包装袋一起放入水中,一段时间后,糖果就会被溶解。可如果只向破口处照射激光,糖果就会被烧穿,形成一个洞,而不是整块糖果被烧没。前一现象就好比等向性刻蚀,而后一现象就如同非等向性刻蚀。
第三个关键词,就是表明刻蚀快慢的“刻蚀速率(Etching Rate)”。如果其他参数不变,当然速率越快越好,但一般没有又快又准的完美选择。在工艺研发过程中,往往需要在准确度等参数与速率间权衡。比如,为提高刻蚀的非等向性,需降低刻蚀气体的压力,但降压就意味着能够参与反应的气体量变少,这自然就会带来刻蚀速率的放缓。
最后一个关键词就是“均匀性”。均匀性是衡量刻蚀工艺在整片晶圆上刻蚀能力的参数,反映刻蚀的不均匀程度。刻蚀与曝光不同,它需要将整张晶圆裸露在刻蚀气体中。该工艺在施加反应气体后去除副产物,需不断循环物质,因此很难做到整张晶圆的每个角落都是一模一样。这就使晶圆不同部位出现了不同的刻蚀速率。
刻蚀的种类:湿刻蚀(Wet Etching)与干刻蚀(Dry Etching)
刻蚀也像氧化工艺一样,分为湿刻蚀(Wet Etching)和干刻蚀(Dry Etching)。还记得上一篇我们说到,取名“湿法”氧化的原因是因为采用了水蒸气与晶圆反应,而刻蚀中的“湿”则意味着将晶圆“浸入液体后捞出”。湿刻蚀的优点是刻蚀速率相当快,且只采用化学方法,所以“选择比”较高。但其问题是只能进行等向性(Isotropic)刻蚀。如果把晶圆浸入液体中,液体就会自由流动与材料发生反应,光刻胶背面的受保护部分也会与液体发生反应,被快速溶解腐蚀,准确度较差。而且,如果光刻胶破口很小,液体刻蚀剂将受自身表面张力影响,无法穿过破口。用光刻机绘制了微细的图形后,若不能照图形制成电路,也只是徒劳。因此,如今在制作半导体核心层时,一般不采用湿刻蚀的方法。
刻蚀则泛指采用气体进行刻蚀的所有工艺,即在晶圆上叠加光刻胶“模具”后,将其裸露于刻蚀气体中的工艺。干刻蚀可分为等离子刻蚀、溅射刻蚀和反应性离子刻蚀(RIE, Reactive Ion Etching)。与湿刻蚀不同,这些干刻蚀工艺采用各种不同的方式来刻蚀材料,所以,可以一目了然地说明非等向性和等向性刻蚀的特点。例如,采用化学反应的干刻蚀为等向性刻蚀,采用物理反应的刻蚀则为非等向性刻蚀。最近,随着RIE(非等向性高、刻蚀速率高的一种干刻蚀方法)成为主流,干刻蚀具有非等向性的认识已成了一种共识
总结
深硅刻蚀技术是半导体制造中不可或缺的一部分,它的发展对于推动电子器件的小型化和性能提升至关重要。随着技术的不断进步,我们期待深硅刻蚀技术能够解决更多的挑战,为未来的电子器件制造带来更多的可能性。


