离子注入工艺介绍
离子注入是一种掺杂技术,通过在真空中将特定元素的离子高速轰击至半导体材料(通常是硅片)中,从而精确、可控地改变其电学性能。它是现代集成电路制造中不可或缺的关键步骤。一、离子注入的目的与作用简单来说,离子注入的目的就是在指定的区域,精确地掺入特定种类和数量的杂质原子,从而形成所需的N型或P型半导体区。这些区域共同构成了晶...
离子注入是一种掺杂技术,通过在真空中将特定元素的离子高速轰击至半导体材料(通常是硅片)中,从而精确、可控地改变其电学性能。它是现代集成电路制造中不可或缺的关键步骤。
一、离子注入的目的与作用
简单来说,离子注入的目的就是在指定的区域,精确地掺入特定种类和数量的杂质原子,从而形成所需的N型或P型半导体区。这些区域共同构成了晶体管、二极管、电阻等所有集成电路元器件的基础。
核心作用包括:
1、形成源极/漏极
在MOSFET(金属氧化物半导体场效应晶体管,最主流的晶体管)中,通过高浓度注入形成N+(对于NMOS)或P+(对于PMOS)区域。
2、调整阈值电压
在晶体管沟道区域进行低剂量注入,以精确控制晶体管的开启电压。
3、形成阱区
在衬底上形成与衬底导电类型相反的区域(如P阱或N阱),用于隔离不同类型的晶体管。
4、形成隔离区
注入氧离子以形成SOI(绝缘体上硅),或注入高剂量杂质以形成pn结隔离。
5、降低接触电阻
在金属与半导体接触的区域进行高浓度注入,形成欧姆接触。
二、离子注入与热扩散的对比
在离子注入技术成熟之前,主要使用热扩散进行掺杂。两者对比如下:
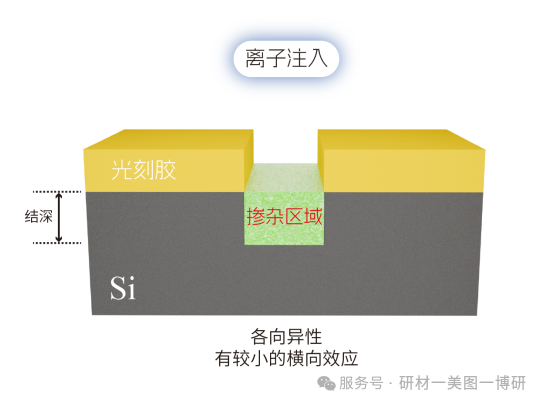
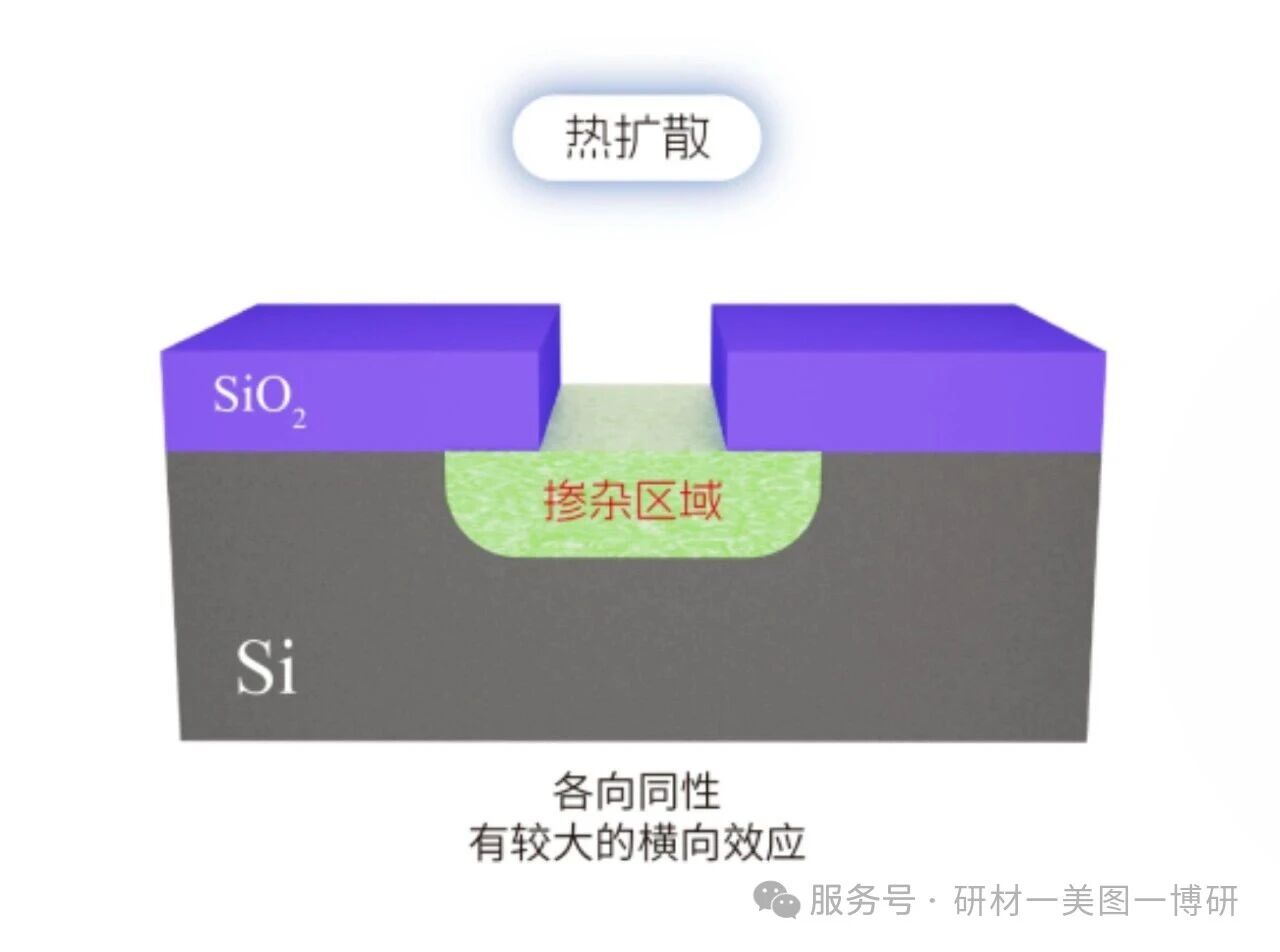

三、基本工艺流程及关键技术参数
1、基本工艺流程
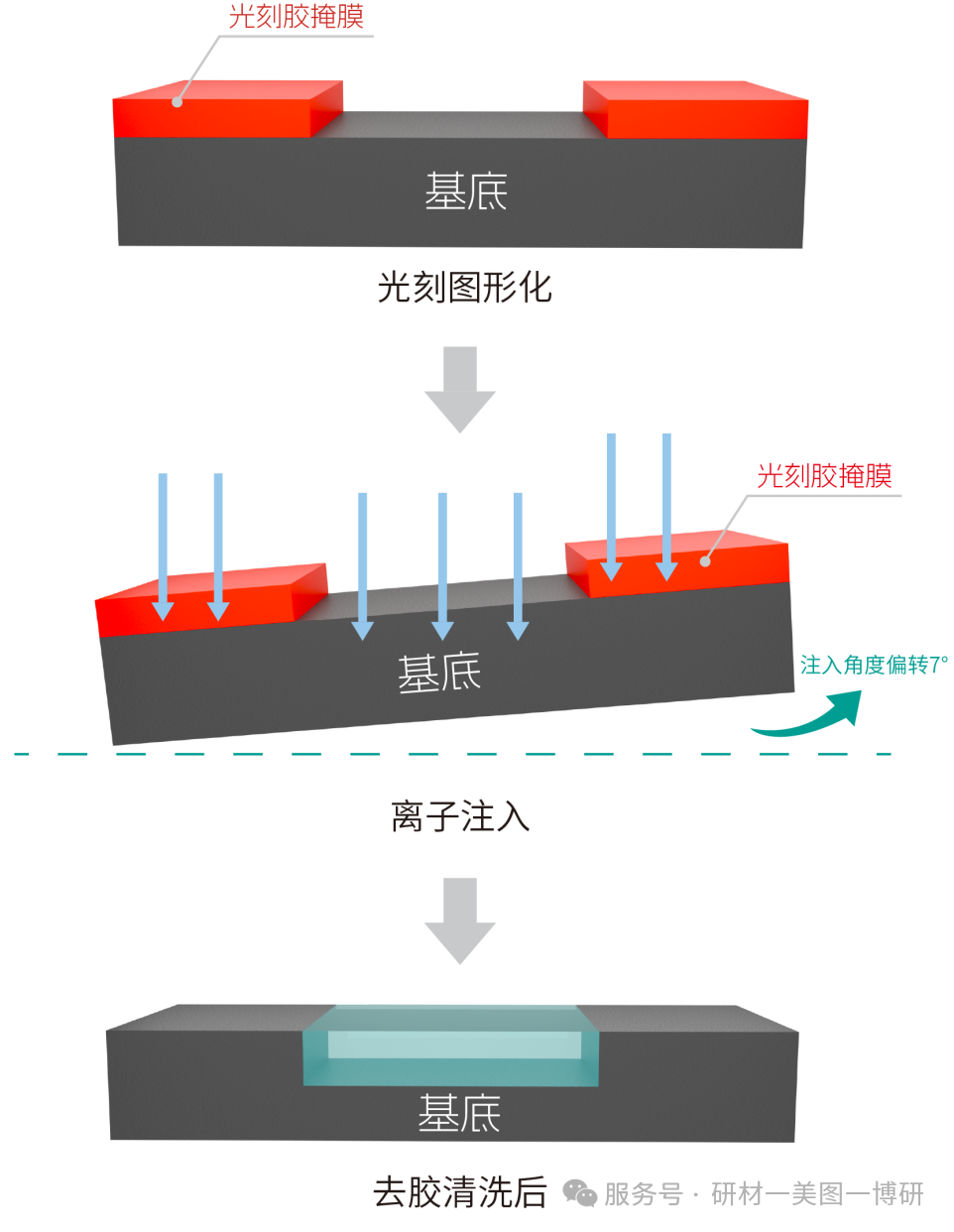
2、关键技术参数
剂量:单位面积硅片注入的离子数量(ions/cm²)。直接决定掺杂浓度。
能量:离子加速电压(keV 到 MeV)。决定注入深度。能量越高,离子穿透越深。
注入角度:为避免离子沿硅晶格通道长驱直入(沟道效应,导致深度不可控),通常让硅片倾斜(如7°)并旋转进行注入。
束流:离子束的电流大小。高剂量注入需要大束流以提高生产效率。
四、光刻胶的选择至关重要
在离子注入工艺中,选择合适的光刻胶做掩膜需要综合考量光刻胶类型、工艺参数、图形CD、材料特性及工艺兼容性。离子注入能量和剂量直接影响光刻胶厚度选择及耐温性(高剂量注入需耐受200℃及以上高温以避免碳化)。
材料特性上需兼顾热稳定性、抗化学腐蚀和机械强度。此外,光刻胶需与设备光源波长匹配,厚胶需优化曝光参数以减少缺陷,并确保显影和去胶工艺兼容。
我司可以为您精准提供最适合的光刻胶,常用的光刻胶列表如下:
AZ5214:高分辨率正胶,耐刻蚀,垂直性好,可反转成负胶,适用于干法刻蚀、lift-off、离子注入等工艺;
AZ10XT:高分辨率厚的DNQ类型的正性光刻胶,侧壁轮廓垂直,高深宽比,单涂层厚度从4.0到>20微米,适用于电镀、离子注入或干法刻蚀/RIE等工艺;
NLOF5510:紫外负性剥离光刻胶,分辨率最高可达0.25微米,大于200℃时仍具有热稳定性,兼容TMAH显影液,适用于lift-off、干法刻刻蚀或离子注入工艺;
RDPI-10-1408:化学放大型国产高分辨率I线正性光刻胶,可用于薄胶快速暴光,低驻波效应,垂直度>85°,适用于集成电路PAD工艺,或高能离子注入工艺等;
RDNI-10-1509:化学放大型紫外负性剥离光刻胶,分辨率最高可达0.4μm,兼容碱性显影液显影,易去胶,适用于lift-off工艺实现金属和电介质图形化,制作集成电路PAD工艺或高能离子注入工艺等;
RDPI-15-0248:I线正性光敏聚酰亚胺胶,具有高分辨率、高耐热性和高绝缘性等优点,兼容普通的碱性显影液,适用于微纳加工及其他微电子应用,例如:集成电路的表面钝化层、离子注入掩蔽层、应力缓冲保护层、倒装芯片安装,以及先进封装等领域。
