离子注入工艺介绍
离子注入是一种掺杂技术,通过在真空中将特定元素的离子高速轰击至半导体材料(通常是硅片)中,从而精确、可控地改变其电学性能。它是现代集成电路制造中不可或缺的关键步骤。一、离子注入的目的与作用简单来说,离子注入的目的就是在指定的区域,精确地掺入特定种类和数量的杂质原子,从而形成所需的N型或P型半导体区。这些区域共同构成了晶...
在MEMS器件的制造过程中,薄膜沉积技术如同微观世界的“基石”,其质量直接决定了器件的最终性能与可靠性。无论是智能手机中的加速度计,还是医疗领域的微型传感器,都离不开精密可控的薄膜沉积工艺。
一、薄膜生长的三个阶段
薄膜生长一般有三个阶段,分别是成核、凝聚和连续膜形成。
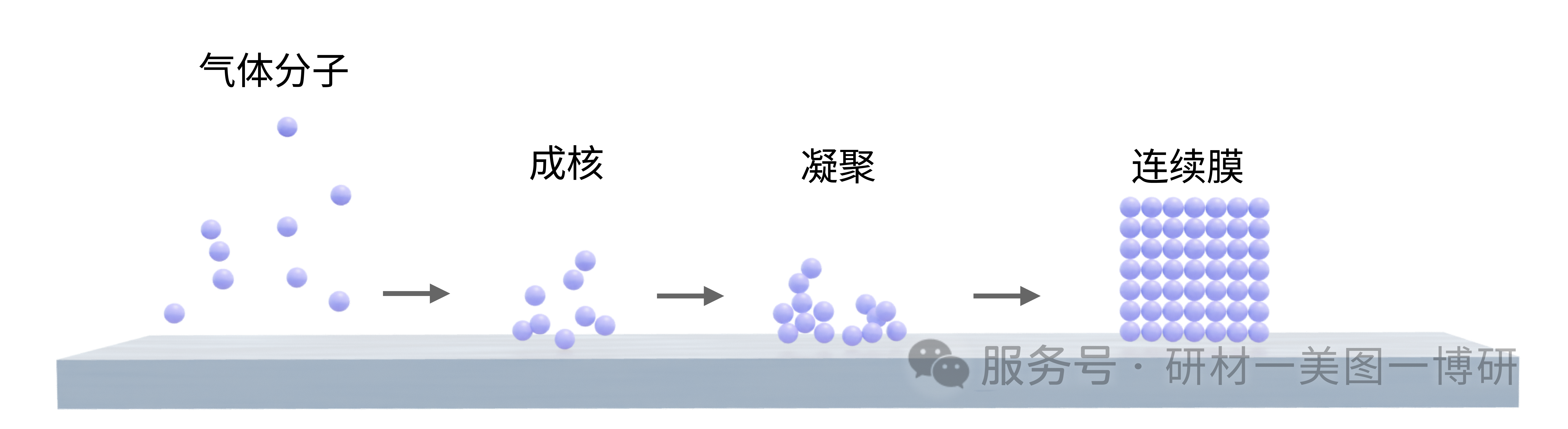
1、成核阶段
气相中的原子或分子在衬底表面扩散并相互碰撞,当聚集到一定尺寸(临界核尺寸)时便形成稳定的晶核;
2、凝聚阶段
新的原子或分子不断吸附到晶核表面,使晶核逐渐长大,形成岛状结构,这些岛状结构会随着沉积的进行继续生长并相互靠近;
3、连续膜形成阶段
岛状结构进一步生长并相互连接,最终形成连续的薄膜覆盖衬底表面。这三个步骤相互关联、依次递进,每个步骤都受到沉积温度、气压、气体流量、衬底材料及表面状态等多种因素的综合影响,共同决定了薄膜的微观结构和宏观性能。
二、薄膜沉积方式分类
薄膜沉积技术主要分为物理气相沉积(PVD)和化学气相沉积(CVD)两大类,各有其独特的适用场景:
1、物理气相沉积(PVD)
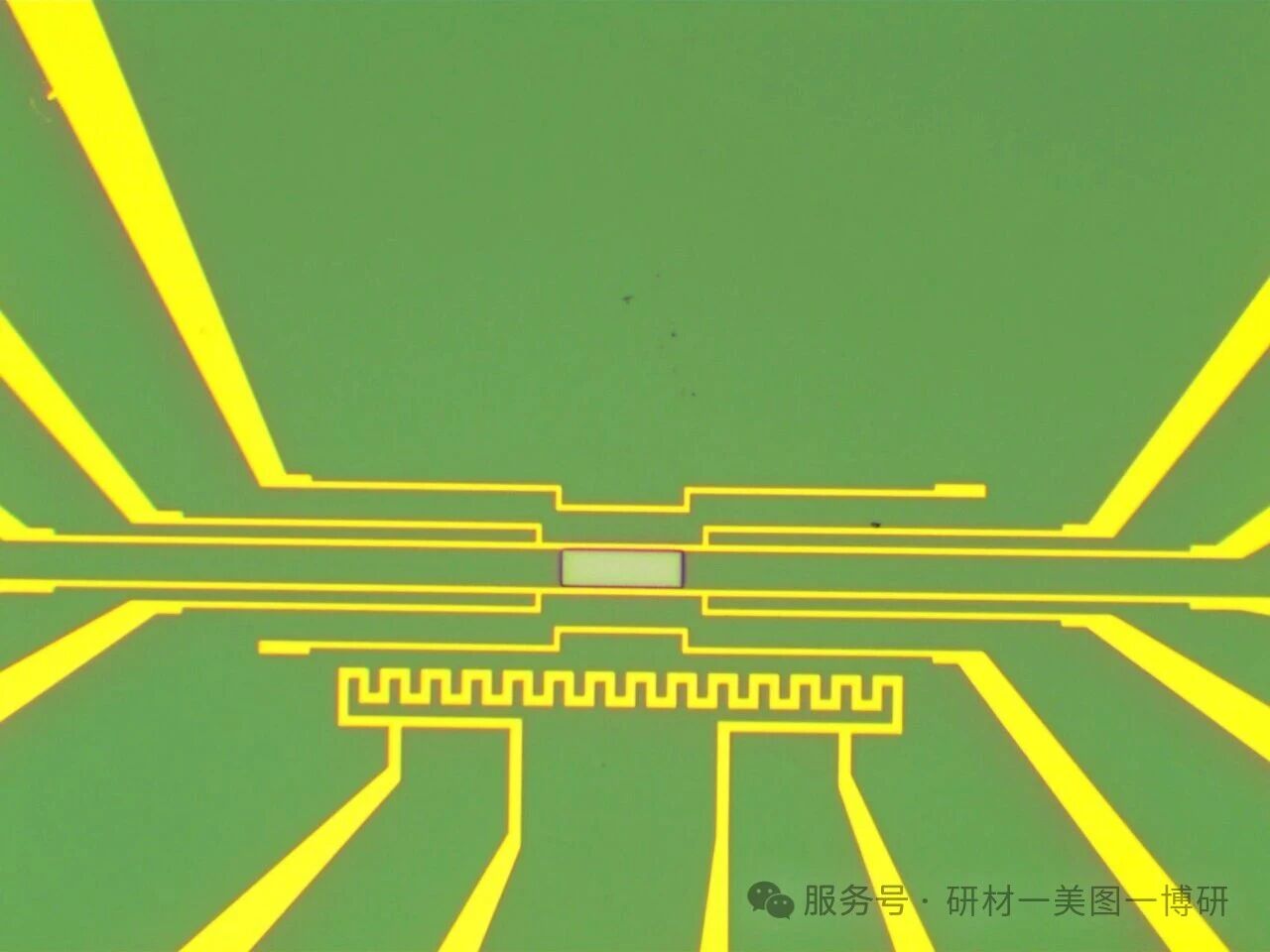
主要通过真空环境下的物理方法实现薄膜沉积。其中,磁控溅射技术利用磁场与电场的协同作用,实现靶材原子的高效溅射与沉积。该技术可制备纯度超过99.9%的金属薄膜,且薄膜与基体的结合强度可达10MPa以上。
PVD技术中的电子束蒸镀利用高能电子束轰击靶材,将电子的动能转化为热能使靶材蒸发汽化,在基底表面凝结成膜,常用于沉积金、铜等金属靶材,在制造微电极时被广泛采用。
2、化学气相沉积(CVD)

低压化学气相沉积(LPCVD)能实现对气体输运的精确控制,能够沉积具有优异均匀性和极好台阶覆盖的薄膜。
等离子体增强化学气相沉积(PECVD)引入等离子体,促进前体材料的分解和沉积,适合低温工艺需求。
原子层沉积(ALD)是基于两种气态前驱体与基底表面的交替自限制化学反应,通过单层生长(每循环0.1-0.3nm)实现原子级别的薄膜厚度控制,对于具有高深宽比沟槽、孔洞等复杂形貌的基底尤为适用。
三、如何获得高质量的薄膜
1、工艺参数控制
溅射功率直接影响等离子体密度与靶材溅射速率,通常MEMS加工中会将功率控制在50-300W的范围内。工作压力在溅射沉积中一般控制在0.1至10Pa之间,较低的压力下,粒子平均自由程增长,有助于提升薄膜的致密性和台阶覆盖性。
2、温度控制
以LPCVD多晶硅为例,沉积温度通常在550℃至700℃之间。温度变化会显著影响薄膜应力,通过后续高温退火(>900℃)处理,可有效释放LPCVD多晶硅薄膜的应力。
3、基片处理
提高薄膜粘附性需控制好基底的洁净度,可通过湿法清洗和等离子干法清洗实现。等离子清洗后,能够显著提高薄膜粘附性。
4、退火处理
退火是释放和调控薄膜应力的有效后处理方法。

四、常见问题及解决办法
在薄膜沉积过程中,常常会遇到一些共性问题,以下是常见问题及解决方案:
· 防止多层薄膜开裂和丘状凸起的方法是降低薄膜应力,防止膜层被氧化。具体措施包括:选择热膨胀系数接近的材料;提高真空度;适当降低沉积速率;完成多层薄膜沉积后不破真空,直接进行退火处理。
· 提升附着力的方法包括:衬底表面清洁与活化(如等离子体处理),沉积前增加粘附层(如铬Cr对于金Au在氧化硅表面),以及优化沉积初期的成核条件。
· 台阶覆盖与均匀性问题对于具有高深宽比或复杂形貌的结构尤为重要。原子层沉积(ALD)技术通过单层生长,能在100-400℃的温度范围内,实现≤±1%的卓越均匀性,非常适合对保形性要求极高的复杂三维结构。
